目前,互连电阻和可靠性是制约先进CMOS电路性能的关键因素。随着晶体管缩放速度的放缓,互连缩放已成为电路小型化的主要驱动力,预计未来CMOS技术节点的互连限制将更加严格。
随着临界互连尺寸接近10nm,目前铜“双大马士革”也变得越来越具有挑战性,替代金属化方案的研究力度在大约十年内不断加强。选择替代金属是一项高度多方面的任务,包括许多标准,包括降低尺寸时的电阻率、可靠性和性能方面,以及可持续性方面。
在本文章中,我们介绍了替代金属基准测试和选择的基本标准,并讨论了该领域的当前技术状况。本教程内容包括接近制造的材料介绍、实际研究中的材料以及基础研究的未来方向。虽然商用CMOS器件中铜金属化的第一种替代品最近已成为现实,但对这种终极互连金属的研究仍在进行中。
介绍
微电子电路是当今生活中几乎每一个方面的无数电子设备的核心元件。逻辑电路、存储单元和传感器不仅用于计算机或手机中,而且用于汽车或医疗应用中来处理、存储和检测信息。 微电子学的成功依赖于底层构件的不断小型化,在基于晶体管的逻辑电路中,著名的摩尔定律就是这一点的缩影。等效缩放定律也存在于其他器件中,例如存储单元。器件尺寸的减小与器件密度的巨大增加相结合,带来了巨大的性能优势,同时也降低了能耗,并且至少对于老一代来说,每个功能的成本大大降低。例如,从1970年到今天,制造一个晶体管的成本降低了109倍。
在公众的认知中,晶体管或电容器单元的缩放历来是焦点。然而,互连的缩放对于支持摩尔定律是同样重要的。互连线和通孔为电路的有源元件(如互补金属氧化物半导体(CMOS)晶体管或存储元件)提供信号、电源和时钟,因此在创建具有高级功能的复杂微电子电路和系统时至关重要(图1a)。作为示例,在逻辑处理器中用作高速缓存存储器的SRAM单元的区域在一个方向上由晶体管的栅极间距(也称为“接触多晶硅间距”)(晶体管尺寸)和垂直方向上的金属线的间距(互连间距)确定(图1b)。因此,为了减小SRAM单元面积,晶体管和互连尺寸两者都应当被缩放。
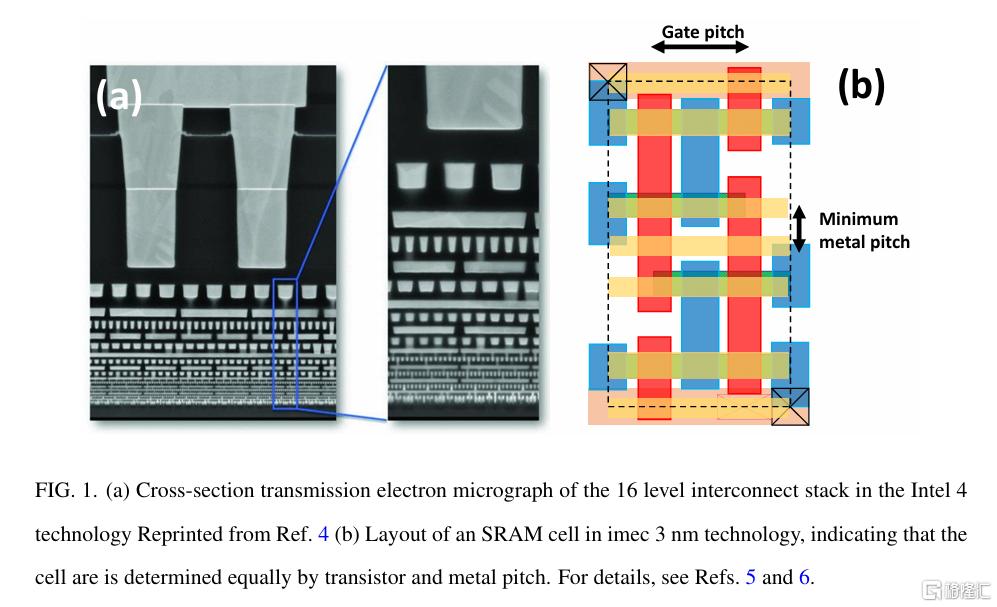
从历史上看,当尺寸减小时,晶体管性能得到改善,从而带来上述性能优势。相比之下,这并不适用于互连。减小导线的横截面积必然会增加其每单位长度的电阻,从而导致更大的能量耗散和增加的RC延迟。如今,在12nm至15nm量级的互连线尺寸下(参见第1A),互连性能通常是先进微电子电路整体性能的主要限制因素。对于晶体管来说,器件结构的变化伴随着互连线的改进。然而,对于互连线来说,结构的选择是有限的,因此,必须通过材料和工艺创新来提高性能。通过使用具有较低介电常数(低-κ ε)的电容器或空气间隙可以实现互连电容的减小。然而,由于所得互连的机械稳定性降低,这导致封装期间的可靠性问题,从而其进展受到阻碍。
1999年以后,取代铝基金属化的铜“双大马士革”方案(图2)由于多种原因正面临着日益严重的问题。
首先,铜需要扩散阻挡层和粘附衬垫以确保互连可靠性。如果没有扩散阻挡层(通常为TaN基),铜漂移到周围的电介质中会导致快速的电介质击穿和相邻线路之间的短路(参见第三章)。
此外,在缩放尺寸下,铜电迁移成为日益严重的问题(参见第三章)。这可以通过在TaN阻挡层和铜之间的粘附衬垫层(通常为Co)以及通过覆盖层来减轻。然而,阻挡层和衬垫层的厚度不能在不丧失其功能的情况下按比例缩小到2-3nm量级的组合厚度。因此,对于具有减小宽度的线,阻挡层和衬垫层(具有高电阻率)占据总的金属化的体积分数越来越大,为铜留下越来越少的空间,而对线的电导率几乎没有贡献。
再者,如下面将要讨论的,由于晶界和表面散射的增加的影响,铜的电阻率对于缩放的尺寸强烈增加。这两种效应——更高的电阻率和减少的Cu体积分数——都有助于在互连缩小时,单位长度的线路和通孔电阻迅速增加。这导致互连性能的迅速恶化,即使对于短的线也是如此。
最后,“双大马士革”制造方案需要逐步进行破坏性修改,以实现具有高机械稳定性的无空隙和无缺陷互连。
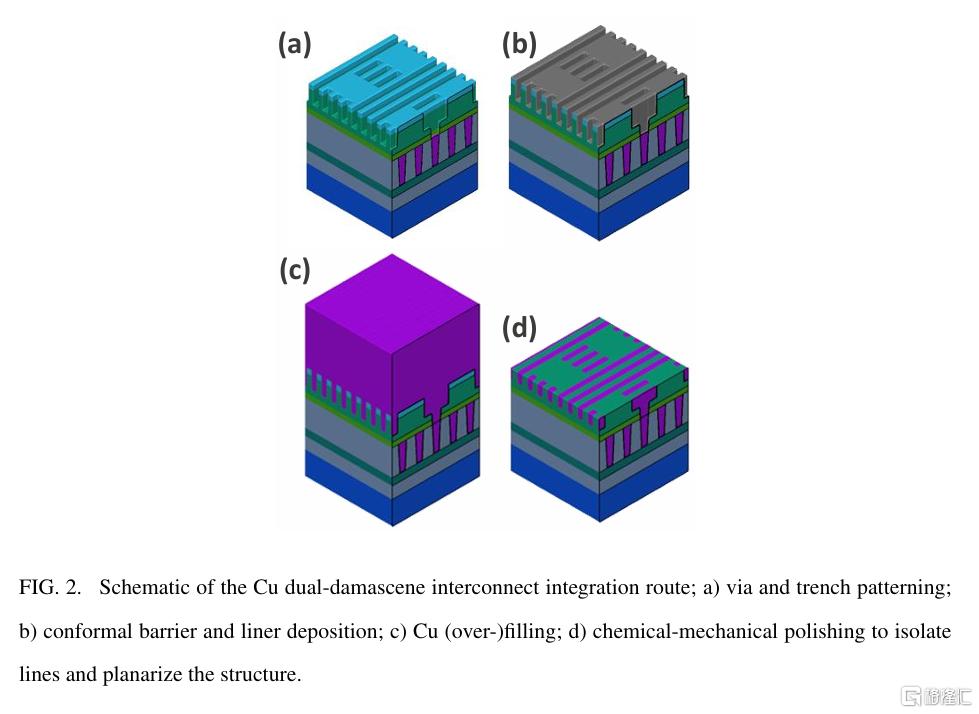
这些问题可以通过选择理想情况下不需要阻挡层和衬垫层的替代金属来缓解,同时对小尺寸电阻率的敏感性较弱。虽然这不能逆转单位长度线路电阻的增加,但我们将在下文中证明,在足够小的线宽下,替代金属和金属化方案的性能优于铜。
在本文中,我们将介绍与选择潜在的替代金属用于高级互连相关的不同方面。甄选过程是多方面的,需要解决许多方面的问题。因此,我们开发了一个多阶段的过程,以识别、筛选和基准测试互连应用的替代金属(图3)。教程的组织结构如下:
我们将首先讨论电阻率对纳米尺寸的敏感性,并介绍材料筛选过程。随后将引入可靠性(TDDB)和电迁移(EM)。本论文还介绍了这一方法在元素、二元和三元金属中的应用,并讨论了目前和未来的研究方向。由于金属选择与未来集成方案之间存在密切关系,我们将在未来技术节点中解决替代金属的集成和工艺问题。
最后,可持续性集成电路对于减少微电子产业的生态足迹正变得越来越重要。因此,我们将引入互连金属的生命周期评估方案,并将其应用于基于上述标准确定的各种有前景的金属。
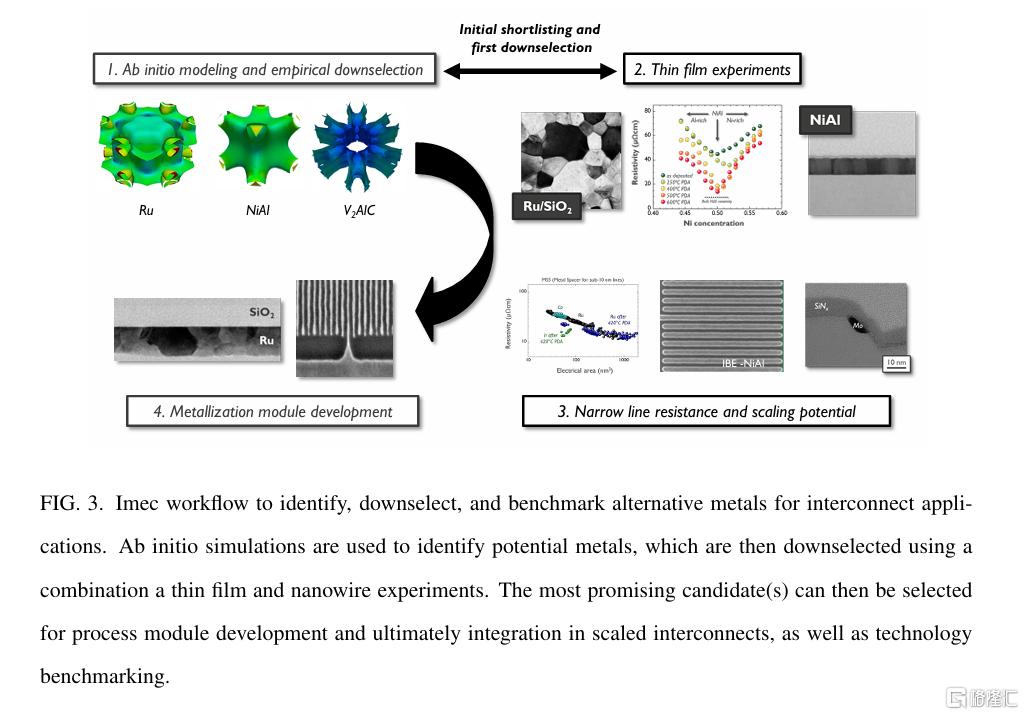
A
未来互连技术目标
从历史上看,互连尺寸的缩放一直由行业范围的路线图驱动,例如半导体的国际技术路线图(ITRS),目前称为国际器件和系统的路线图(ITRDS)。然而,目前还不存在行业范围的路线图,并且技术节点命名法也变得模糊不清。目前,商用先进微电子芯片中的最小互连间距在表1的顺序排列,逻辑电路中互连尺寸(最小金属间距)的路线图。改编自参考文献。有关当前技术水平,请参见参考文献和(HVM =大批量制造; GAA =全方位栅极; CFET =互补场效应晶体管)

表1
25纳米,在未来十年内预计将进一步减少(见表1),在不久的将来达到低于10nm的预测线宽。这是特别重要的,因为接触的多晶硅间距(晶体管栅极间距)不能进一步小型化。 因此,未来的重要领域收益,例如SRAM单元,需要主要来自晶体管架构以及互连间距缩放。
如上所述,如此小的线宽可能与当今互连中使用的铜“双大马士革”(图2)不兼容。虽然铜“双大马士革”的进一步优化仍在进行中,但表1中路线图中的最小互连尺寸将需要使用潜在的新材料,工艺以及集成方案的颠覆性方法。如表所示,互连线和通孔的相关尺寸将在约5和10 nm之间的范围内,这可以用作金属选择以及工艺开发的指导。
纳米尺度的金属电阻率
几十年来已经知道,金属纳米结构(例如薄膜或纳米线)的电阻率通常比相应的大块金属电阻率高得多。
这是互连缩放的主要问题,因为这导致线和通孔电阻的增加比单独减小几何尺寸所预期的要快得多,特别是在低于10nm的目标尺寸范围内。电阻率的增加归因于粗糙表面或界面以及晶界处散射的综合效应。为了定量描述,对于具有顶和底表面/界面的薄膜,已经发展了各种传递模型。然而我们注意到,目前还没有一个等效的一维传递模型可以描述具有四个环绕表面的导线。然而,基本的定性行为预计是相当类似的,因此“薄膜衍生”电阻率模型已被用来了解纳米线的缩放性能。
A
体金属和纳米结构中的电子传递
1. 电子传递的半经典描述
了解低维电阻率增加的最常用方法是基于玻尔兹曼输运方程(BTE:Boltzmann Transport Equation)。BTE描述了载流子分布不平衡的统计,例如,当施加电场时,该电场的强度会随时间而变化。




此部分有诸多公式,放原文方便大家理解
如前所述,Eq(7)的推导假设声子和晶界散射的Matthiessen规则是有效的。对于无序度较大的纳米晶近非晶薄膜,可能违反了Matthiessen规则。在这种薄膜中,局部化效应变得很重要,这通常伴随着相对于体行为的显著降低的温度依赖性(电阻率的温度系数)。
然而,Eq(7)的推导并不要求对表面散射、晶界散射或声子散射都成立Matthiessen规则。事实上,由于晶界散射对平均自由程的“重整化”,在Ref中已经指出,对于金属薄膜中的表面散射和晶界散射,Matthiessen规则通常不成立。这使得单独量化体积、表面散射和晶界散射对薄膜电阻率的贡献变得困难,并且应该谨慎使用公式(7)的某些近似版本,将表面和晶界散射的贡献分开。
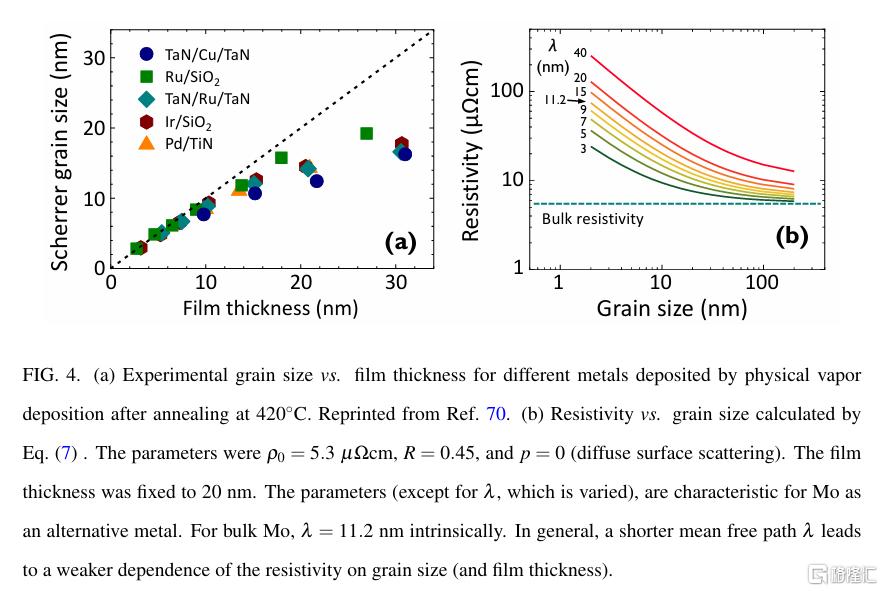
2. 薄膜电阻率缩放的材料依赖性
Eq(7)包含了该问题的五个独立材料参数:体单晶电导率、电子平均自由程、薄膜表面/界面处散射的镜面度、平均晶粒尺寸和晶粒反射系数。在实践中,人们经常发现的晶粒尺寸对膜厚的强烈依赖性,这导致了第二个间接的源的厚度依赖性的薄膜电阻率,除了表面散射。 晶粒尺寸和膜厚之间的关系ℓ(h)强烈地依赖于沉积工艺参数,并且不是材料本身的唯一函数。 虽然有时假定线性关系,但在相关厚度范围内,通常在实验上观察不到这种关系(见图4a)。 它也可能受到沉积后退火的影响,这可能导致晶粒生长或再结晶。
因此,仅根据体性质定量预测金属纳米结构的电阻率是不可能的。如前所述,ℓ(h)的关系取决于沉积过程特征和热收支;由于实验表明晶界散射可以主导薄膜的电阻率,因此金属的筛选应包括获得大晶粒薄膜(或纳米线)的可能性。然而,这不能通过(从头算)计算来实现,因此,晶粒尺寸和退火行为的实验研究需要补充传输和可靠性代理,以实现更现实的金属评估。
第二个限制是难以计算或预测参数R和p的实际值。R描述了电子在晶界的反射概率,它通常取决于晶界两侧晶粒的(相对)取向和晶界的原子构型。一般来说,计算和实验一致地观察到小角度或巧合晶界(低R)与大角度随机晶界(大R)之间的R有很大差异。在多晶薄膜中,相关R将是所有晶界构型的有效平均值,因此取决于微观结构。虽然某些具有内聚能的趋势——更大的内聚能有望导致更大的R——似乎是合理的,但R不能被认为只取决于金属。
此外,表面散射镜面率p不仅与金属本身有关,还与周围界面或表面的性质有关。预计包层材料和界面或表面粗糙度都将起主要作用。虽然从理论上和实验上研究了表面散射率作为表面粗糙度的函数,但理论和实验之间的定量一致尚未建立。因此,计算不能预测,不能用于筛选。此外,由于对包层材料和表面粗糙度的潜在依赖,表面散射不能被认为是一种材料性质。
然而,上一节表明,由于表面或晶界散射,电阻率的增加与载流子的整体平均自由程λ成比例。因此,大R、小晶粒或扩散界面的影响可以通过短λ来减轻。如图4b所示,以ρ0 = 5.3µΩcm, R = 0.45, p = 0(漫射表面散射),固定厚度为20 nm为例,用Eq.(7)计算薄膜电阻率与晶粒尺寸的关系。结果表明,较短的平均自由程λ使得电阻率对晶粒尺寸的依赖性较弱,从而减轻了晶界散射的影响。在扩散表面散射的情况下,薄膜电阻率随薄膜厚度的变化也有类似的规律。因此,这导致了寻找具有短λ的金属作为Cu的替代品。Cu的平均自由程可以达到高达40nm的值,这与典型的互连尺寸和晶粒尺寸相比是很大的。因此,平均长度短得多的金属对互连结垢的敏感性要低得多。一种基于ab-initio的筛选短λ金属的方法将在第IIC节中描述。完整的替代金属筛选过程,包括其目前的状况将在第四节中详细说明。
3. 各向异性对薄膜电阻率缩放的影响
上述模型假设一个球面各向同性费米表面(具有有效质量的自由电子气体),因此体电阻率和薄膜电阻率都不依赖于电流的结晶方向。这样就可以推导出Fuchs-Sondheimer Eq.(5)和Mayadas-Shatzkes Eq.(7)。由于复杂性大,目前还没有薄膜电阻率模型能够结合表面和晶界散射考虑金属的详细能带结构。虽然Mayadas-Shatzkes模型(Eq.(7))已经能够很好地描述实验测量,但缺少对模型参数R和p的定量理解限制了对不同金属的球面费米表面近似精度的评估。
应该注意的是,从宏观的角度来看,立方系统的电导率是各向同性的,因此,用球面费米面近似可能是合适的。然而,其他不对称的(六角形、四角形、正交形、单斜形、三角形)结构会导致大块金属的各向异性电导率。以六角形钌为例,其沿六角形轴的电阻率低于两个垂直(平面内)方向。为了描述这种情况,我们建立了一个半经典的mayadas - shatzkes模型来描述脂质费米曲面。这种模型可以表示具有六角形、四角形或正交晶体对称的金属,数学细节超出了本教程的范围,但该模型发现费米表面各向异性对表面散射有很强的影响,而不影响晶界散射。图5显示了使用参考文献中的模型,体电阻率与薄膜的关系是费米表面有效质量各向异性的函数。这里忽略了晶界散射(R = 0),只有表面散射是有效的。
结果表明,对于面内电导率大(面内有效质量小)、面外电导率小(面内有效质量大)的二维金属,表面散射逐渐被抑制,同时由于表面散射导致的薄膜电阻率对厚度的依赖性降低。

原则上,这种效应可以用来降低纳米线的电阻率,因此,已经提出了二维和一维金属(具有单一高导电性晶体地理方向)用于互连应用。然而,有两点值得注意。由于Matthiessen规则一般不适用,因此存在强晶界散射(不受降维影响)导致二维金属的表面散射受到抑制,从而降低了小晶粒金属因各向异性而具有的优势。此外,在互连中使用一维金属需要单晶金属,以便电流方向始终与高导电性的晶体方向对齐。目前,在商业互连中没有可行的单晶线集成路线,因此,这种考虑目前仅限于基础材料科学。
B
金属中的点缺陷、无序和合金散射
在介绍基于平均自由程λ的第一性原理筛选方法来识别和选择有前途的互连应用金属之前,我们简要介绍了对复合金属非常重要的其他散射源。
一般来说,晶体中任何偏离周期性的地方都会使电子散射。元素金属含有空位(或空位团簇)缺陷或杂质。在相关金属的典型多晶高质量薄膜中,空位和杂质限制了低温下的电阻率,但在室温下通常可以忽略不计,在室温下,声子、晶界和表面的散射占主导地位。
然而,对于复合金属来说,情况就大不相同了。合金是一种本质上无序的材料,其晶格上不同原子的分布是随机的。由此产生的晶体因此不是周期性的,由于合金散射导致高电阻率。这在图6中说明了Cu-Au系统的开创性情况。无序无序CuxAu1−x合金的电阻率远大于单质金属Cu和Au,在Au的50%处电阻率最大,无序程度最大。相比之下,该体系还包含两种有序的金属间相:Cu3Au和CuAu。接近这些有序相的化学计量,电阻率显示出一个明显的最小值,远低于无序无序合金。
这些观察结果表明,为了实现与互连应用相关的复合金属的电阻率,需要避免合金散射。因此,除了不会引起这些问题的元素金属外,只有有序的金属间化合物对替代金属筛选工作具有潜在的兴趣。测量和优化薄膜金属间有序的挑战加剧了这一问题。更多的细节和技术状况的总结可以在Secs中找到。IVC和IVD。
C
替代金属的初始筛选
如果不详细了解微观结构,就不可能预测薄膜或纳米线的电阻率,而微观结构与工艺有关。此外,像Eq.(7)这样的电阻率模型假设一个球形费米表面(自由电子气体),并且金属特有的标度特性仅由单个平均自由程值表示。虽然可以根据第一性原理计算金属的电子-声子限制电阻率,但考虑到详细的能带结构,这在今天的计算中仍然非常密集,将实际系统的大小限制在每个单元电池的几个原子。主要的瓶颈是电子-声子耦合弛豫时间的计算。
此外,用这种形式包括晶界是很麻烦的。所有这些问题都限制了建立完全预测下选择方法的可能性,这种方法可以立即确定直接互连应用中最有前途的金属候选材料。因此,金属选择问题需要分阶段解决,如图3所示。尽管如此,通过所谓的ρ0λ值可以筛选潜在感兴趣的金属,该值可以用有限的计算努力通过从头算方法计算。在下面第四节中将描述筛选元素和化合物金属的总体方法的应用。




此部分有诸多公式,放原文方便大家理解
D
存在表面散射的薄膜和纳米线的电阻率缩放
虽然它已成功地应用于筛选元素和化合物金属,上述方法是近似的。在实际中,载流子的平均自由程在很大程度上取决于它们的波矢量k。如图7所示,Cu的平均自由程沿费米面方向分布广泛。因此,重要的是在输运计算中包括全各向异性带结构以及筛选工作,以获得更准确的小尺寸电阻率图像。
方程(4)描述了包括所有相关散射机制在内的体弛豫时间的重新标度。请注意,晶界散射原则上包括在(有效)平均自由程中。假设一个球面费米曲面可以得到方程7中描述的解析Mayadas Shatzkes模型。包括完整的电子能带结构会导致:

其中τ0nk为包括声子和晶界散射的弛豫时间。当忽略后一种散射事件(即仅包括声子和表面散射)时,薄膜电阻率可以从头开始预测。Cu的计算薄膜电阻率随薄膜厚度的变化如图7所示。注意,Eq. 12表明,薄膜(或纳米线)的电阻率不仅取决于输运方向,还取决于表面法向(生长方向)。
这甚至适用于具有各向同性体积导电性的金属,例如包括Cu在内的所有立方金属,并且可以通过减小尺寸的对称性来理解。
对于具有可忽略晶界散射的单晶薄膜,尽管采用通常的密度泛函理论近似,但结果原则上是准确的。原则上,纹理薄膜中的晶界散射可以通过晶粒尺寸相关的平均自由程来增加,但这取决于微观结构,并且不容易通过最先进的从头算技术来解决。
除了输运计算之外,上述模型还可用于推导薄膜或纳米线的优值,相当于Eq.10的ρλ。例如,对于纳米线,这会导致:

这个性能值包括各向异性输运的影响,例如第IIA1节中讨论的表面散射的抑制,适用于有织构的单晶线,尤其是单晶线。对于某些晶体取向的材料,它可以产生非常有吸引力的价值。然而,值得注意的是,随机多晶薄膜和电线是用平均方法表征的,表面散射是在所有晶粒方向上平均的。此外,对于以晶界散射为主的薄膜或纳米线(如小晶粒多晶薄膜),对生长取向的依赖程度降低。在这种情况下,使用10对金属进行基准测试是最合适的。
互连可靠性
选择新的互连金属化方案的第二个重要方面是金属和介电的可靠性。互连故障可能由于金属或电介质故障而发生。与线路电阻类似,当导线和过孔小型化时,互连的可靠性往往会降低。最初,Al有限的电迁移性能导致了20多年前Cu作为主要互连金属化的引入。目前,铜金属化的可靠性面临着越来越大的压力。正如下面更详细解释的那样,为了确保可靠性,需要屏障层和衬垫层,但它们需要与互连尺寸一起缩小,以便为Cu导体留出一些空间。由于其可扩展性有限,屏障和衬管最终将占据互连体积的很大一部分,而对整体电导的贡献很小。正如将在第五节中所示,垒和无衬里金属化对于低电阻互连至关重要,优于当前的铜金属化方案。
下面,我们将介绍电介质和金属可靠性的基本原理。第四节将介绍特定元素和二元替代金属可靠性的最新技术状况。
A
介电击穿和阻挡层的需要
随时间变化的介电击穿 (TDDB:Time-dependent dielectric breakdown ) 是一个物理过程,其中介电材料在低于其固有击穿强度的恒定电场下会随着时间的推移而降解并最终击穿。这是由于电介质中形成导电路径(细丝),使相邻金属电极短路。快速失效可能是由逐渐的介电损坏引起的(例如,空位形成)或通过相邻电极(此处为互连线或通孔)的金属漂移。在后一种情况下,由于施加的电场,金属离子漂移穿过电介质,污染电介质,导致泄漏,并最终导致电介质击穿和互连线短路。
TDDB 行为很大程度上取决于所使用的材料,包括金属和电介质。对于金属,存在热力学势垒,用于(电离)金属原子的分离及其漂移或扩散到(低-K)电介质。一般来说,这种势垒与金属的内聚能成比例。因此,对于难熔金属,该势垒明显高于铜,从而抑制金属离子向电介质中的漂移和扩散,从而获得更长的 TDDB 寿命。我们注意到金属离子的漂移和扩散 里面 电介质对金属内聚能的依赖性明显较小,而是取决于电介质中金属杂质的结合能。然而,对于与互连相关的金属,热力学势垒由分离能给出,因此具有更高内聚能的金属(更难熔的金属)预计将表现出大大改善的 TDDB 寿命。
另一方面,电介质的选择也会影响互连的 TDDB 性能。当今先进互连中使用的电介质具有低介电常数(低介电常数)K)以减少互连电容。低介电常数 K 这些电介质的连接由于低偶极子密度,或者本质上是由于成分或通过降低物理密度, 例如,通过引入孔隙率。这会对 TDDB 行为产生相当大的影响,因为众所周知,铜在此类电介质中会快速分离和漂移,从而导致快速击穿。
因此,铜需要在电介质和铜金属化之间引入(更难熔的)阻挡层,以阻止铜脱离和漂移到电介质中。一般来说,非晶势垒金属优于多晶势垒金属,因为晶界可以充当扩散路径。
如今,阻挡层由 TaN 制成,其厚度可以缩小到约 1 至 1.5 nm,而不会损失功能。替代阻隔材料的研究仍在进行中, 例如,在掺杂 Zn 的 Ru 上,但它们的集成通常并不简单,预计它们不会比 TaN 屏障有大的改进。
除了固有的材料特性之外,工艺限制和尺寸缩放本身也会进一步降低 TDDB 性能:窄间隙、线边缘粗糙度、等离子体损伤或未对准(见图 1)。因此,为先进互连寻找合适的替代金属原则上不仅应基于其固有性能(固有金属分离势垒),而且还应基于对其集成步骤的影响,因为在先进互连中实施新材料可能会导致增强的介电击穿。
因此,使用合适的测试结构(例如平面电容器 (PCAPS))通过实验评估 TDDB 性能非常重要或侧壁电容器(SWCAPS),122 用于向下选择有前途的替代金属。
TDDB 的主要驱动力是施加的电场以及互连的温度。实际上,TDDB 限制了相邻线路之间可以安全施加的最大电场,因此对于电路设计和布局非常重要。商业电路的 TDDB 寿命规格在高达 135 的温度下通常为 10 年. 这样的寿命太长而无法直接测量,因此必须通过外推加速测量来提取可靠运行的最大电场。 在高温和电场下。在文献中,关于使用哪种模型进行 TDDB 寿命外推一直存在争论,并且已经提出了几种模型,例如:
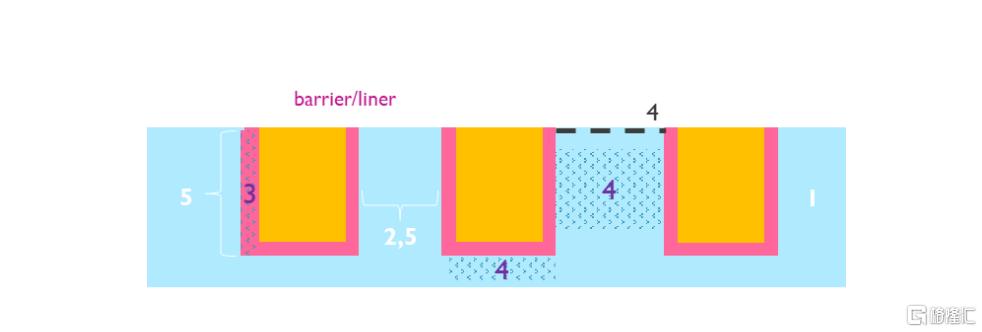
图8. 说明对 TDDB 和互连寿命的不同影响: 1) 电介质的固有特性、击穿位置和机制; 2)绝缘介质的厚度; 3)阻隔性能和导体金属脱离; 4)集成引起的介电损伤, 例如、阻挡层沉积、化学机械抛光、蚀刻、吸湿、 ETC。); 5) 线路变异性(线路边缘粗糙度、沟槽高度、通孔未对准、 ETC。
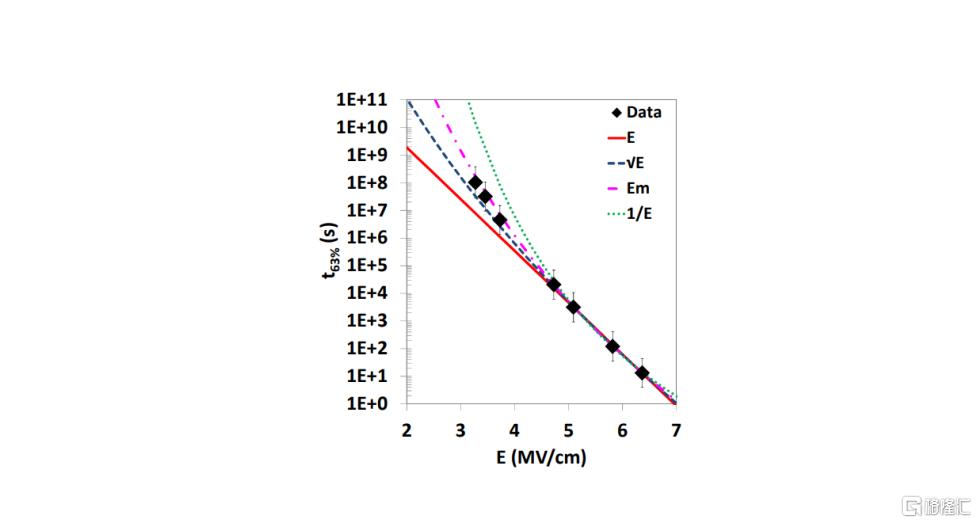
图9. TDDB 寿命外推可用模型的比较 与 使用 TDDB 数据进行测量。

这里, t50% 指示时间,在此之后线路以 50% 的概率出现故障。冲击损伤模型(幸运电子模型)被认为最能描述TDDB的底层物理机制。然而,一些作者更喜欢使用幂律模型来拟合 TDDB 数据,因为它提供了良好的预测并且具有有限数量的拟合参数。123,125,126 相比之下,镶嵌结构的研究已经发现E- 和 √E-模型也是如此,在拟合低场 TDDB 数据时保守。不同模型的行为以及与 Cu 实验 TDDB 数据的比较如图 9 所示。请注意,需要额外的面积缩放和外推至低故障百分位,以获得行业相关互连的故障率和操作条件限制。
加速TDDB测试还可以用于研究底层机制,例如,击穿是通过介电失效还是通过金属丝形成发生。典型的偏置温度应力 (BTS) 实验在高温下使用 PCAP 或 SWCAP,例如, 通过三角电压扫描 (TVS) 或施加恒定电压(见图10)。对于具有不同电极(一个是感兴趣的金属,另一个是难熔金属)的电容器,可以通过研究正偏压和负偏压下的击穿来证明金属漂移(并与本征击穿区分开来)。在“弱”顶部电极上施加正电压应力期间, 例如,PCAP(图10a),在没有合适的扩散势垒的情况下,金属离子漂移到电介质中(图10b),而负电压应力不会发生金属漂移(图10C)。这允许金属漂移和其他固有电介质击穿机制的分离,因为后者不依赖于偏置极性(参见图10d 和 e)。
或者,在三角电压扫描期间,当漏电流在第一次电压扫描期间增加但在后续扫描期间消失时,可以检测到金属漂移,这表明金属离子已迁移通过电介质(见图10f-i)。这种 TDDB 测量可以在各种温度和电压下进行,以研究与本征击穿、金属细丝生长和细丝形成相关的各种条件。由于这些机制的主导地位是由金属、介电材料及其厚度决定的,因此有必要不断修改替代金属和先进互连的方法。
从 TDDB 的角度来看,Cu 互连缩放的关键限制是需要阻挡层来防止导体金属脱离和漂移到周围的电介质中。在按比例缩放的互连中,互连尺寸减小,此类势垒具有比铜高得多的电阻,并且由于线宽的缩放,占据了互连线体积的很大一部分,并最终阻碍了超小线宽的适当金属填充。正如第五章中进一步讨论的那样。这会导致线宽低于 10 nm 的缩放互连的线电阻大幅增加,并最终强制引入无障碍替代金属化。
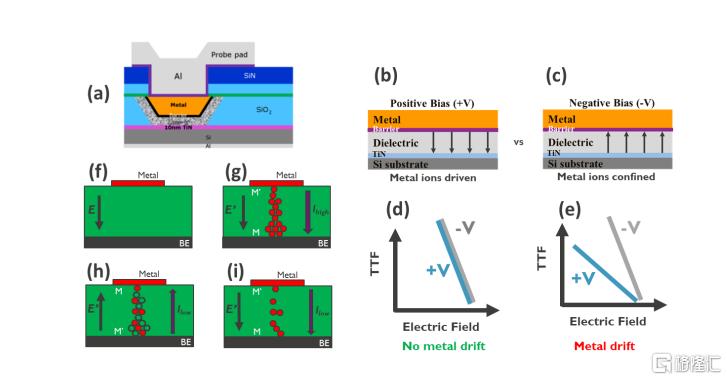
图 10. (a) 用于确定 TDDB 寿命的平面电容器 (PCAP) 的器件结构。(b) 和 (c) 恒压应力下的金属漂移过程示意图。对于 "弱 "金属顶电极,在正电压下金属离子会漂移,而在负偏压下不会发生金属漂移。(d)和(e)显示了相应的失效时间(TTF)行为与施加偏置电压 ±V 的函数关系。(f)至(i)显示了在三角形电压扫描过程中金属丝的形成和溶解,外加电场 E 如图所示。
B
电迁移
众所周知,电迁移 (EM:Electromigration) 是集成电路 (IC) 中的主要故障机制之一。当电流流过导体时,金属原子受到两种力:电场产生的直接力和移动电子的动量转移(或电子风)产生的力(图 11a)。
随着时间的推移,电子风会导致金属原子沿着电子流的方向从阴极迁移到阳极。结果,阴极侧会出现金属原子耗尽,从而形成空隙(图11b 和 c) 并最终导致线路开路。
同样,金属原子将聚集在阳极一侧,促进小丘的形成(图 11b),并最终导致短路。
描述电磁过程的驱动力 FEM(也称为电子风力 Fwind)134 可表示为

其中 ρ 为金属电阻率,je 为电子电流密度,Z∗ 为有效离子价,e 为电子电荷。
爱因斯坦方程将原子质量通量 J 与电子风联系起来

其中,C 为原子浓度,D 为扩散常数 D = D0 exp - EA kBT,D0 为沿不同路径的有效扩散系数,EA 为主要扩散路径的活化能,kB 为玻尔兹曼常数,T 为温度。
在金属线中,原子可以沿着几条路径扩散:在金属线的主体中、沿着晶界以及在金属和电介质的界面上。主要的扩散路径与材料有关,由其活化能 EA 决定,而活化能 EA 又由晶体金属晶格的键能决定。在铜互连中,电磁导致的空洞通常在铜和介质屏障(通常为 SiN 或 SiCN)之间的顶部界面成核,空洞的生长将通过晶界继续进行。
缩小互连尺寸的影响之一是界面和晶界处扩散原子的体积迅速增大,同时金属体积减小。因此,按比例互联中能够可靠承载的最大电流密度(135◦C 下的寿命为 10 年)会降低,从而导致电路设计和布局受到越来越严格的限制。通过在 TaN 层和导体之间引入衬垫层,特别是在线路顶部引入衬垫层,按比例互连中电磁寿命的缩短得到了缓解(减缓)。
目前使用的主要衬层材料是 Co,Ru 也是一种替代材料。然而,与防止铜漂移到周围电介质的 TaN 阻挡层类似,衬垫层的厚度也很难调整。预填充技术可能是一种替代方法,可提高可靠性,但会增加工艺复杂性。这就减少了主导体金属(即铜)的空间,当尺寸缩小时,线路电阻会迅速增加。
替代衬垫缩放的另一种方法是使用其他导体金属,这些金属对电磁具有较大的三相电阻,大大优于铜。由于电磁的活化能 EA 通常与金属的内聚能成正比,因此熔化温度高的难熔金属很有前途。我们注意到,这类具有高内聚能的金属在无障碍 TDDB 可靠性方面也很有前景,这表明不同可靠性方面的材料依赖性是相关的。第五节将进一步讨论选择对无屏障和无衬垫可靠金属化方案具有良好前景的替代金属的重要性。
C
自热和热特性
如上所述,金属互连的可靠性主要取决于芯片中互连结构临界点的 ab 溶质温度以及金属堆栈中的温度梯度。互联结构中达到的温度取决于互联结构的热阻、互联结构与发热晶体管之间的热耦合、互联结构中的自加热以及金属线之间的热耦合。
金属互连尺寸的不断扩大,加上低介电常数介电材料的引入,导致人们对互连温度越来越关注。由于层间电介质的热传导率通常很低,例如 OSG 3.0(一种介电常数为 κ = 3.0 的有机硅玻璃)的热传导率为 0.3 W(m K)-1通过互连堆栈的热传导主要是通过金属线和通孔进行的,并且在很大程度上取决于金属传导率和金属连接方案。减少金属线的宽度和厚度会降低热导率,增加电阻率(见第二章),这导致互连堆栈的热阻增大,成为先进封装整体热阻的主要因素,并导致金属互连的自热升高。
由于互连结构的热行为由金属主导,因此准确预测替代金属的热特性非常重要。互连级热模型148,149 可以包括金属线密度、通孔密度和不同金属层之间连接性的影响,但还需要包括有关尺寸相关行为的额外信息。
为了捕捉包括电子和声子在内的弹道热传导效应,可以使用 ab initio 模拟来预测材料的热导率。块状金属的总热导率是根据所有电子和声子模式的累积贡献计算得出的,即:

其中 C 是热容量,v 是群速度,τ 是弛豫时间。下标 el 和 ph 分别表示电子和声子的贡献,k 和 q 分别表示电子和声子的波函数。在半导体材料中,声子主导热传导,而电子是金属的主要热载体。因此,对于金属而言,导热系数 K0 和电阻率 ρ0 通过韦德曼-弗兰茨定律联系在一起

L 为洛伦兹数,T 为温度。对于自由电子,L = 2.4 × 10-8 WΩK-2。许多块状金属的洛伦兹数接近自由电子值(如 Cu150),但铂族金属151 或 W150 的洛伦兹数要高出 10-15% 左右,这是因为声子传输对热导率的影响。
为了将金属尺寸减小对热导率的影响考虑在内,我们采用了基于 Mayadas 和 Shatzkes 模型(见第 II 章 A 1 节)的薄膜模型,利用反射系数和表面镜面参数的经验心理校准数据(另见第 IV 章),得出了不同金属(叠层)的热导率随尺寸变化的估计值。根据这一模型,可以得出声子和电子对总热导率的贡献。图 12a 显示,在先进互连结构的相关尺寸中,声子的贡献率仍远低于 15%,这表明热传导端口由电子主导,且维德曼-弗朗茨定律仍(近似)适用。图 12b 显示了几种金属随厚度变化的热导率。热导率与尺寸相关的行为受到电子平均自由路径以及晶界和表面散射特性的影响。虽然理论和实验表明洛伦兹数可能会降低,但对于纳米级尺寸的金属膜和金属丝而言,洛伦兹数是否会发生强烈变化仍是一个未决问题。
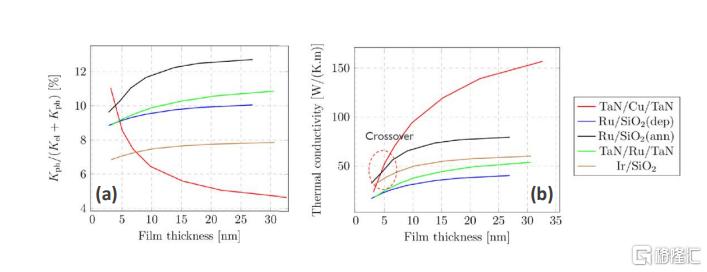
图 12. 随厚度变化的热导率趋势:(a)声子传输对总热导率的贡献。(b) 与厚度有关的总热导率,包括声子和作为热载体的电子。
向下选择替代金属
由于制造接近目标尺寸的纳米级线路既复杂又昂贵,而且在许多情况下由于缺乏工艺技术而无法实现,因此在潜在的大量候选金属中直接通过实验识别出最有利的金属是不可行的。因此,最初必须设计一种程序,根据可从多种材料中获得的代用指标来识别和筛选最有前途的金属。很明显,这套代用指标并不是独一无二的,历来采用的方法也略有不同,但如上所述,它应涵盖纳米级金属电阻率和可靠性。然后,可以通过薄膜实验等方法进一步了解候选金属的特性,并按照图 3 中的工作流程,将其作为预期线路性能的第一近似值。下面,我们将介绍这一研究的现状和取得的认识。
A
元素金属
根据第二章和第三章的讨论,提出了以下三种材料特性,作为按比例互联中金属预期整体性能的代用指标:
(i) 体积电阻率 ρ0
(ii)电荷载流子的平均自由路径 λ 或体电阻率与电荷载流子平均自由路径的乘积 ρ0 ×λ
(iii) 内聚能或熔化温度
根据第二章的讨论,前两个代用参数代表了小尺寸下潜在的低电阻率。第三个参数可视为电迁移硬度和无障碍可靠性的代用参数,因为一般来说,难熔金属的性能会更好(见第 III 章)。第一个代用参数 (i) 可从文献中获得。ρ0的第一原理计算是可能的,但非常耗费资源,因此不能用于筛选广泛的金属。与此相反,ρ0 × λ(或等效张量的分量)可以比较容易地从原子弹初始计算中获得,详见第 II 章 C )。第三个替代值可以从文献(熔点)或计算(内聚能)中获得。通常情况下,熔点和内聚能之间具有良好的相关性(见图 13a)159,160,因此它们可以互换使用。在实践中,体积电阻率与平均自由路径 ρ0 ×λ 的乘积被用作金属的优劣值。然而,ρ0 ×λ 不应在不考虑代理 (i) 即体电阻率的情况下单独使用。虽然这对于元素金属来说很简单,但对于二元和三元金属来说可能会带来问题,因为对于这些金属,即使是基本特性的了解也很有限,这将在下文中讨论。

图 13. (a) 各种元素的计算内聚能与熔化温度的关系。(b) 对于电阻率低于 20 µΩcm 的各种元素金属,根据计算的 ρ0 ×λ 乘积与实验电阻率 ρ0 的关系推导出的平均自由路径 λ。铜的位置突出显示,以供参考。虚线表示 Cu 的 ρ0 ×λ 乘积的预期趋势,即 ρ0 ×λ = 6.8×10-16 Ωm。
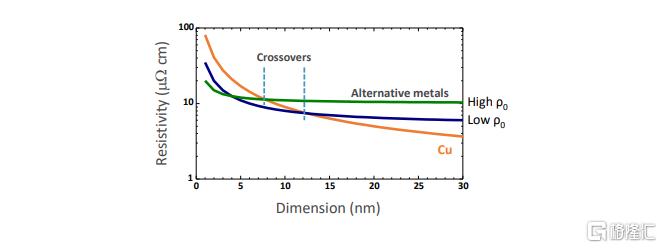
图 14. 定性电阻率比例说明。平均自由路径 λ 较小的其他金属在较小的尺寸(如薄膜厚度)上显示出与铜相似或更低的电阻率。
单独使用 ρ0 ×λ 值的主要问题在于 ρ0 和 λ 是相互关联的,因为平均自由路径短(弛豫时间短)会导致电阻率大(参见公式 (3))。图 13b 展示了从 ρ0 × λ 乘积推导出的许多元素金属的平均自由路径与体积电阻率的对比。如图 14 所示,对于铜来说,短 λ 确实会导致电阻率的厚度依赖性减弱,从而导致电阻率交叉。不过,即使对于恒定的 ρ0λ 乘积,替代金属的较低体电阻率 ρ0 仍然是有益的,因为与具有较大 ρ0 的金属相比,它通常会导致在较大厚度上与铜的交叉(图 14)。虽然具有最小 λ 的金属可能最终显示出最低的电阻率,但交叉可能发生在与实际互连应用不太相关的尺寸上。
上述近似值可用于元素周期表中的所有金属元素。以铜的 ρ0×λ (6.8 × 10-16 Ωm)、10 µΩcm 的体积电阻率和铜的熔点 (1358 K) 作为临界值,可以确定表 II 中最吉祥的金属元素,并以铜的特性作为参考。表 II 中列出了最吉祥的金属元素,并以铜的特性作为参考。列表中包含几种过渡金属,包括几种铂族金属,如 Ru、Rh 和 Ir。
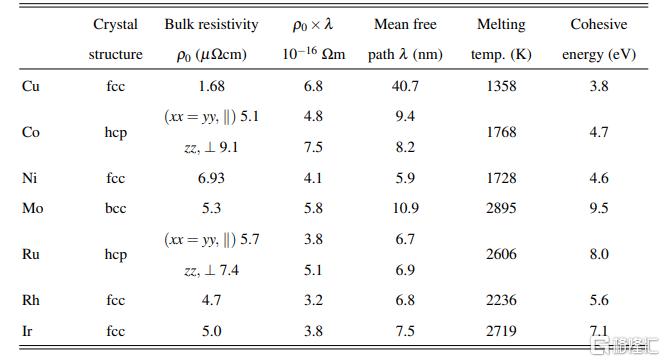
表 II. 未来替代金属以及作为参考的铜的特性:晶体结构、体积电阻率、计算得出的 ρ0×λ 优越性(见第二章 C 节)、推导出的平均自由路径 λ、熔化温度和计算得出的内聚能。
由于有前景的元素数量较少,因此都可以按照图 3 中的工作流程进行薄膜实验研究。图 15 显示了各种元素金属薄膜电阻率的厚度依赖性。正如预期的那样,由于平均自由路径较长,铜的电阻率随着厚度的减小而迅速增大,尤其是薄膜厚度低于 10 纳米时。相比之下,许多其他元素金属的电阻率增长要弱得多,根据金属的不同,在厚度低于 5 至 10 纳米时,薄膜电阻率与之相当,甚至更低。尤其是几种铂族金属,如 Rh、Ir 和 Ru,显示出较低的电阻率,这使得这些金属在未来的互连应用中可能极具吸引力。电阻率建模70 发现,与铜相比,薄膜厚度依赖性较弱,最终薄膜电阻较低,这与作为关键参数的平均自由路径较短有关。

图 15. 几种潜在替代金属的薄膜电阻率与金属叠层(薄膜)厚度的关系。有关铂族数据,请参见参考文献 70 和 163。
另一种值得关注的潜在金属是钼,它的薄膜电阻略高,但在互连集成方面具有多种优势,而且成本比昂贵的铂族金属低得多。因此,钼也被视为逻辑和存储器互连应用的候选材料。
图 16 中的结果表明,与最先进的铜大马士革互连器件相比,铱互连器件的电阻率缩放效果更好,而 Ru 和 Co(在较小程度上)在足够窄的线路上显示出相似的电阻率。这些结果证实了薄膜结果,因此这些材料具有替代铜用于互连金属化的潜力。请注意,尽管电阻率相当接近,但由于 Ru 的导电体积更大,因此在无阻挡层和衬垫的情况下,其线路电阻比 Cu 高得多。这将在第五章中进一步讨论。
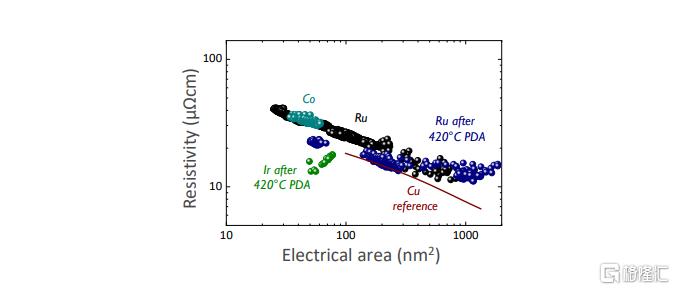
图 16. Co 和 Ru 金属化薄膜在沉积时的电阻率数据;Ir 和附加 Ru 的数据则是在 420◦C 进行沉积后退火后的数据。图中显示了铜双大马士革金属化的参考线。
除了对薄膜和纳米线电阻率进行评估外,还将一些选定的替代金属集成到按比例放大的互连线路中,以研究其可靠性,特别是对阻挡层的需求。目前已获得 Co、Ru 和 Mo 的具体结果。
在具有超薄低κ 薄膜的先进技术节点中,事实表明,保持疏水界面和连续厚的阻挡层对最大限度地降低金属漂移风险至关重要,这对先进互连中钴金属化的集成性和可扩展性提出了重大挑战。相比之下,钼已被证明是一种很有前途的无屏障集成替代材料,无需在二氧化硅、有机硅玻璃或 SiCO 介电薄膜上形成附着层或屏障。这一结果已被多项研究证实。
Ru 是铜的第二种潜在无屏障替代材料。由于 Ru 具有较高的内聚能和出色的抗氧化性,因此可以在无阻挡层的情况下进行集成,尽管可能需要一个较薄的附着促进层。进一步的研究证实,当 Ru 与 0.3 nm 的 TiN 附着层集成时,Ru 的可靠性不会受到影响,没有发现金属漂移的迹象。此外,根据大马士革 TDDB 结果,Ru 与致密的低κ电介质(κ = 3.0)结合后,寿命可达 10 年。
此外,Mo 和 Ru 互连器件都具有出色的电迁移性能。图 17 显示了钼互连器件电迁移测试的一个示例。
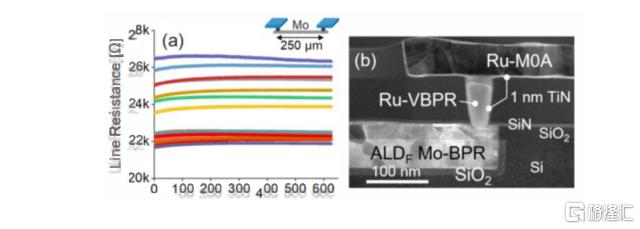
图 17. (a) Mo-Ru 混合互连器件在 330◦C 和电流密度 J = 5 MA/cm2 > 600 小时条件下的电迁移测量结果,显示没有出现故障。(b) 显示了测试结构的横截面 TEM 图像。转载自参考文献.
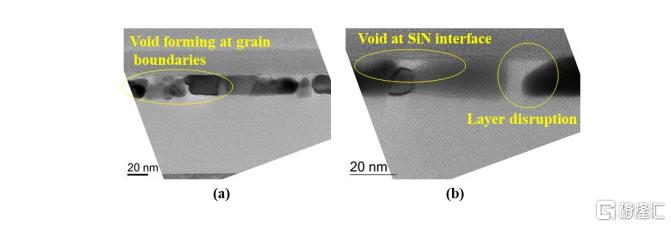
图 18. Ru 互连中电迁移故障的透射电子显微照片,显示 (a) 晶界空洞和 (b) 介电界面空洞。转载自参考文献 184.
此外,在高电流密度(J > 30 MA/cm2)条件下,试图诱导无栅 21 nm 金属间距 Ru 互联线发生电磁故障,但未获成功,这证实了 Ru 具有出色的抗电磁性能。182 在同一研究中,还使用无栅 Ru 互联线在更高电流(150-200 MA/cm2)条件下进行了大量研究,这将诱发高自热(∼ 260◦C)。只有在这些极端条件下,晶界和介电界面才会形成空隙(图 18)。此外,Beyne 等人183 通过低频噪声测量研究了无阻挡层和粗糙表面的缩放 Ru 线,发现金属/电介质界面成为主要的扩散路径。
按照图 3 的工作流程对元素金属进行建模和实验筛选的结果汇总于表 II。表 II 总结了按照图 3 工作流程对元素金属进行建模和实验筛选的结果。我们发现六种元素金属具有先进互连金属化的潜在意义:铂族金属 Rh、Ru 和 Ir,以及过渡金属 Ni、Co 和 Mo。虽然商用 CMOS 电路的局部互连中已经集成了 Co 173-175,但 Mo 和 Ru 因其即使在无阻挡层的情况下也具有高可靠性,在最终规模的线路和通孔中引起了极大的兴趣。目前,结合气隙的无阻挡 Ru 金属化似乎是间距低于 20 纳米的互连系统中的佼佼者,而 Mo 则是研究最深入的替代品。
B
石墨烯和石墨烯-金属混合金属化
然而,纯石墨烯是电荷载流子密度较低的半金属,由于具有较高的薄层电阻,这严重阻碍了石墨烯在互连器件中的直接应用。最近,通过石墨烯与 FeCl3 的插层,电阻率值与铜相当(甚至更低)。插层过程保留了石墨烯的狄拉克锥,同时允许调节费米级,从而产生电荷载流子。然而,即使是高掺杂的插层石墨烯,在与金属通孔共同集成时,接触电阻仍然是一个挑战。不同的 n 型插层种类可能会带来潜在的改进,但要证明插层多层石墨烯能成功集成到按比例的互连器件中,还需要做更多的工作。
除插层石墨烯互连外,还研究了石墨烯-金属混合复合金属化方案。例如,对多层石墨烯封盖的 Ru 薄膜进行的评估显示,与未封盖的 Ru 薄膜相比,片电阻和有效电阻率降低了约 10-20%(见图 19b)。这与费米级降低 0.5 eV 有关,可能是通过 Ru 的电荷转移导致了石墨烯的 p 型掺杂。在铜/石墨烯混合金属化方案中也观察到类似的片电阻和线电阻降低现象。虽然许多实验都集中在包括单层石墨烯在内的混合材料上,但双层或多层石墨烯可能会进一步降低电阻,尽管电荷屏蔽和层间电阻可能会限制额外的好处。
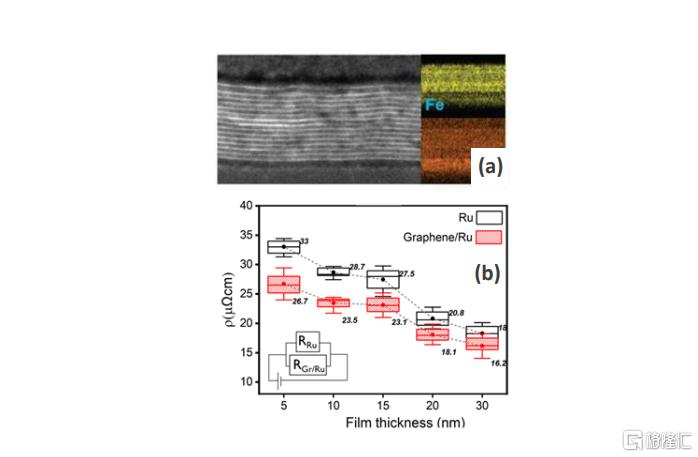
图 19. (a) FeCl3 插层石墨烯的横截面透射电子显微镜照片和 EDS 化学图谱。转载自参考文献 198. (b) 不同 Ru 厚度的裸 Ru 和石墨烯封层 Ru 电阻率测量结果。转载自文献 200。
除了这些薄膜研究之外,石墨烯-金属混合复合材料的集成还面临着一些挑战。沉积高质量石墨烯所需的沉积温度通常高于互联处理的热预算(约 400◦C),因此需要开发无缺陷石墨烯的低温工艺204 。此外,在集成时,例如在金属图案化方案中,石墨烯最好选择性地沉积在图案化互联线路的侧壁上,以避免相邻线路之间的短路。另外,还研究了将石墨烯集成到大马士革互连器件中205 的方法,从而获得了巨大的电子迁移优势。然而,未来的研究还需要证实这种混合方案在实际规模互连器件中的优势。
C
二元金属间化合物
上述对元素金属的分析应被视为详尽无遗,因为没有一种潜在的金属尚未得到评估。因此,为了进一步拓宽材料范围,最近对化合物金属进行了探索。在二元化合物金属中,只有有序金属表现出较低的体积电阻率(见第 II 章 B 节)。相比之下,无序化合物(合金)由于合金散射贡献大,通常具有较大的电阻率。然而,对于有序金属间化合物而言,在较窄的成分范围内,实验观察到许多系统都具有较低的电阻率。图 6 显示了金-铜系统的一个众所周知的例子,其中包括金属间化合物 AuCu3 和 AuCu。图中显示,这些金属间化合物的电阻率可能远低于同一材料体系中无规合金的电阻率,甚至与组成元素金属的电阻率相当。
对于二元金属间化合物的基准和下选,第 IV 章 A 节中讨论的元素金属代用指标同样适用。然而,由于潜在金属间化合物的数量巨大,而且对其中许多化合物的了解有限,因此无法进行与元素金属类似的全面基准测试和降序选择。不过,正如第二章 C 节所概述的那样,ρ0 ×λ 的优越性可以通过 ab initio 计算得到。熔点可从文献(如二元相图)中获得。如果不知道熔点,则可以计算内聚能。Ab initio 筛选工作发现了大量具有低 ρ0 ×λ 产物且内聚能大于 Cu 的二元金属间化合物(图 20),但只有少数金属间化合物的性能优于 Ru。不过,金属间化合物的一个主要问题是,在许多情况下,体电阻率 ρ0 还没有报告。因此,无法像元素金属那样直接进行类似的全面下选。
最有前途的材料包括 NiAl、AlCu、Al2Cu、AlRu 和 Al3Sc。最有前途的材料包括 NiAl、AlCu、Al2Cu、AlRu 和 Al3Sc。最有前途的材料包括 NiAl、AlCu、Al2Cu、AlRu 和 Al3Sc。表 III 总结了这些铝化物金属间化合物的特性,并将其与表 II 中有前途的元素金属进行了比较。实验证明,这些铝化物的薄膜电阻率较低,尽管大多是相对较厚的薄膜 ≫ 10 纳米。
通过在 420°C 高温下沉积镍铝,并在原位添加硅帽以避免表面氧化,可进一步降低电阻率,在此条件下,22 纳米厚薄膜的电阻率为 18 µΩcm。通过将背稀化实验与外延相结合,可以进一步优化较小厚度的 NiAl 电阻率,从而使 Ge (100) 上 7.7 纳米的外延 NiAl 电阻率低至 11.5 µΩcm。
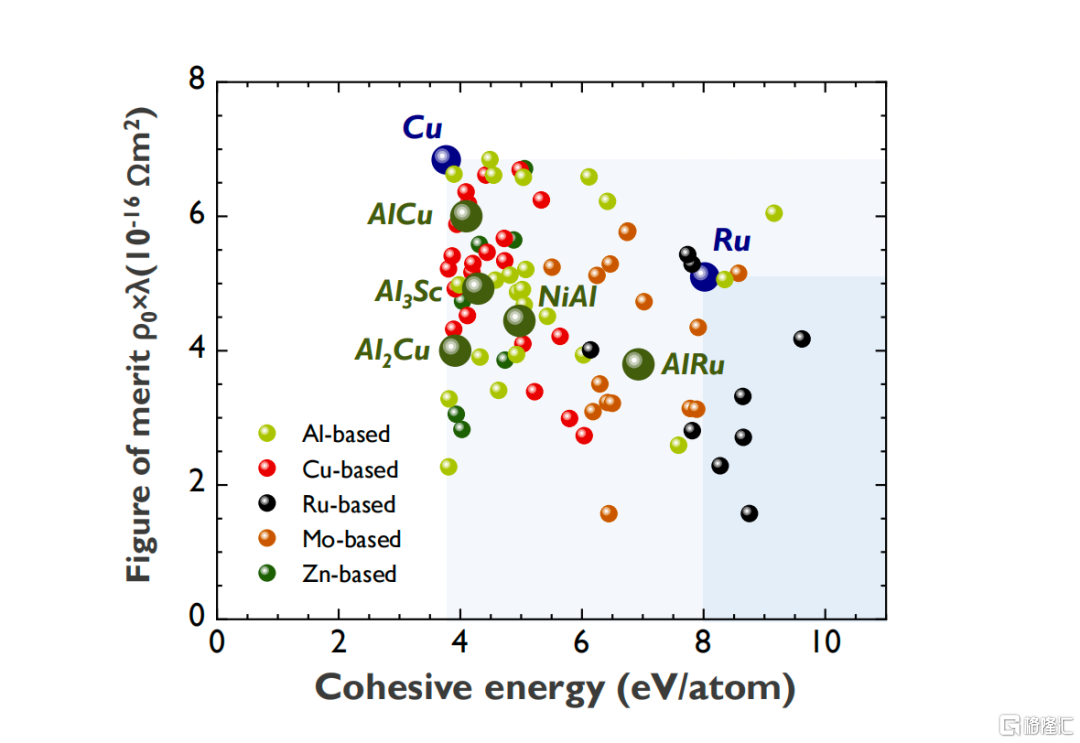
图 20. 二元金属间化合物的 Ab initio 筛选:计算的 ρ0 × λ 乘积与计算的内聚能对比。图中标出了几种铝基金属间化合物,根据文中提到的筛选程序,这些金属间化合物很有希望。
在这些条件下,22 nm 厚的薄膜电阻率为 18 µΩcm。通过将back-thinning 实验与外延相结合,可以进一步优化较小厚度镍铝的电阻率,从而使 Ge (100) 上外延镍铝在 7.7 nm 时的电阻率低至 11.5 µΩcm。
厚度在 10 纳米以上的 AlCu 和 Al2Cu 薄膜的电阻率低于 20 µΩcm,厚度在 30 纳米左右的薄膜的电阻率低于 10 µΩcm。在薄膜厚度为 10 nm 及以上时,Al2Cu 的电阻率低于 Ru,而在研究的整个厚度范围(5 至 30 nm)内,AlCu 和 Al2Cu 的电阻率均优于 Mo。在 8 纳米以下,这两种化合物也显示出与 TaN/Cu/TaN 相似的电阻率。此外,Al2Cu 在 TDDB、EM 和 BTS 中表现出优异的间隙填充性能和良好的可靠性,但要证实 AlCu 和 Al2Cu 在高级高可靠性互连中的应用前景,还需要进一步的工作。
另据报道,24 纳米 Al3Sc 薄膜在 500°C 沉积后退火后的电阻率为 12.6 µΩcm。电阻率受到晶界散射和点缺陷(无序)散射的共同限制,看来很难进一步提高。AlRu 也被列为替代铜的潜在候选材料,尽管迄今为止实验电阻率仍然很高。作为替代金属的潜在金属间化合物的特性(包括作为参考的铜):晶体结构、体积电阻率、计算的 ρ0 × λ 优越性(见第 II 章 C 节)、推导的平均自由路径 λ、熔化温度和计算的内聚能。请注意,AlCu 和 Al2Cu 在 850 K 和 900 K 之间显示出向不同高温相的转变,而不是向液相的转变。
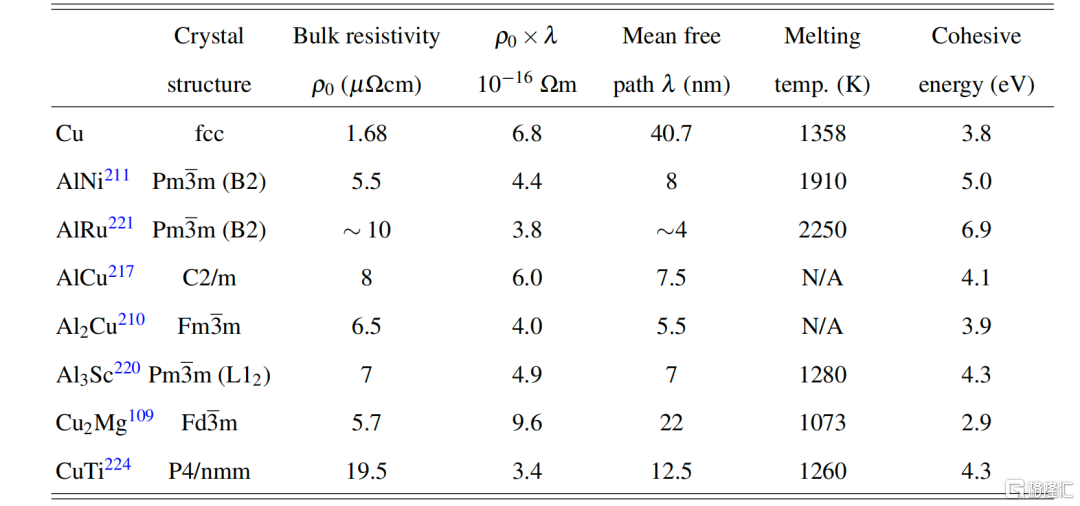
与本文讨论的其他铝相比。
就 Cu2Mg 而言,据报道,5 nm厚的薄膜电阻率为 25.5 µΩcm,通过溅射回流具有良好的间隙填充性能。然而,由于 Cu2Mg 和 SiO2 之间的界面反应,在底层 SiO2 层中形成了很厚的 MgO 层。因此,将 Cu2Mg 集成到低电阻线路所需的(接近)零界面形成的按比例互联电路中是值得怀疑的。
与元素金属相比,二元金属间化合物还面临多种挑战,如结晶有序性和减少点缺陷的需要、成分及其均匀性的控制、次生相的形成、团聚、(界面)反应性或非驰豫表面氧化,如图 21 所示。一个主要挑战是控制二元金属间化合物的成分,如 Al1-xNix 和 AlxSc1-x 系统所示。如图 22 所示,AlxNi1-x 的电阻率在化学成分为 Al0.50Ni0.50 时急剧减小(图 22a)。图 22b 显示了 AlxSc1-x 的类似观察结果。
根据第二章 B 节的讨论,电阻率的增加可以理解为非化学计量点缺陷的产生,它导致了强烈的无序散射。实验结果表明,要获得低而均匀的电阻率,需要将成分控制在(优于)1% 的水平,而这在大批量生产中是具有挑战性的。我们还注意到,在图 22 中的两种情况下,只有在沉积后高温退火后才能观察到低电阻率,这可归因于热激活有序(点缺陷减少)和晶粒生长。因此,需要仔细考虑这些退火步骤与器件加工流程热预算的兼容性。

图 21. 金属间化合物面临的共同挑战
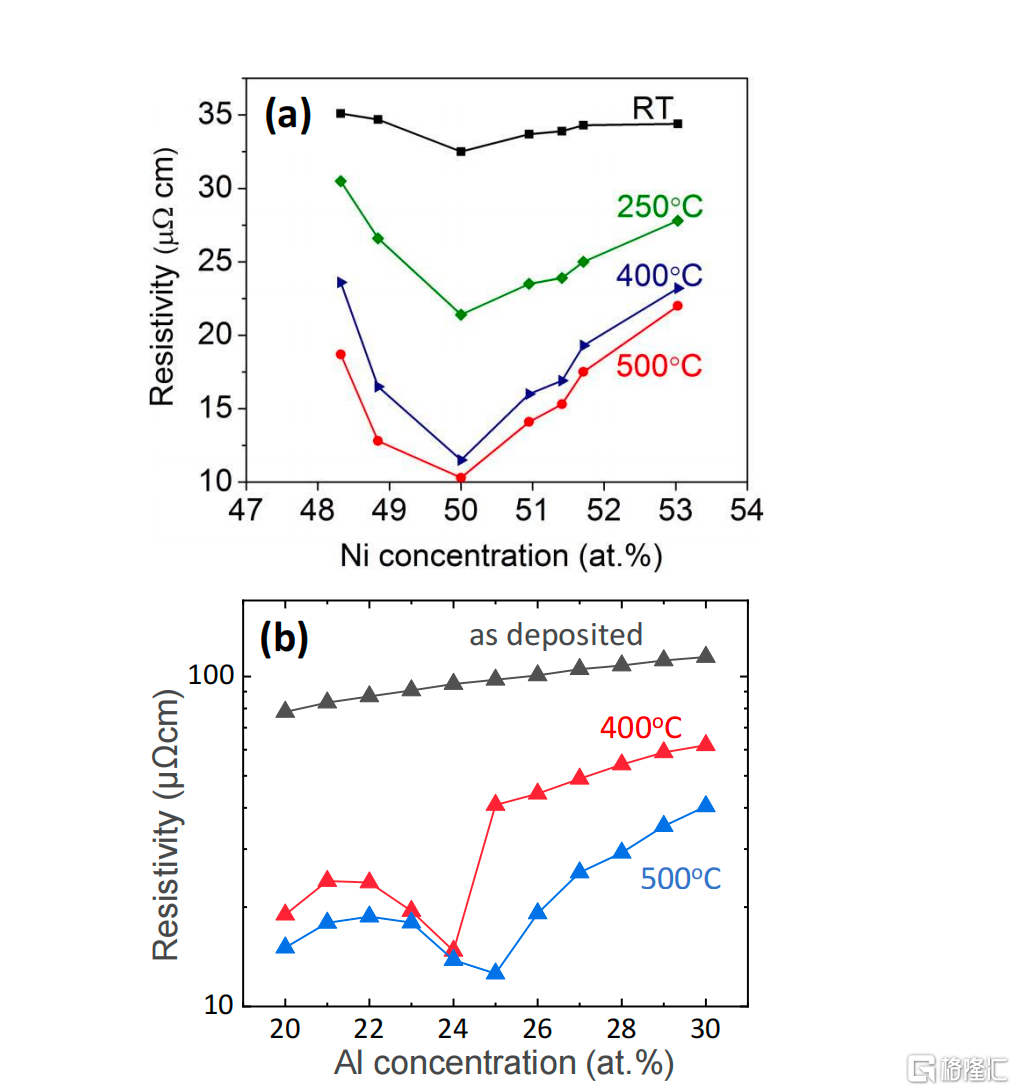
图 22. (a) Al1-xNix 的电阻率与镍浓度的关系。转载自参考文献 211. (b) AlxSc1-x 的电阻率与 Al 浓度的关系。
作为与二元金属间化合物有关的其他挑战的一个例子,我们展示了图 23 中沉积的镍铝 薄膜在空气中暴露后的横截面 TEM 图像和相关的 EDS 化学分析。化学分析结果表明存在原生表面氧化物,但其化学计量(近乎纯 Al2O3)与薄膜主体不同。这可以用元素特异性表面过程来解释,例如制约原生氧化物形成的金属外扩散。
尽管具体的氧化物成分取决于材料系统,但我们发现铝金属间化合物具有这种相对普遍的特征。 因此,在沉积后,也可能在图案化后,这种(铝)金属间化合物最终可能需要原位表面钝化步骤才能集成到按比例互连器件中。
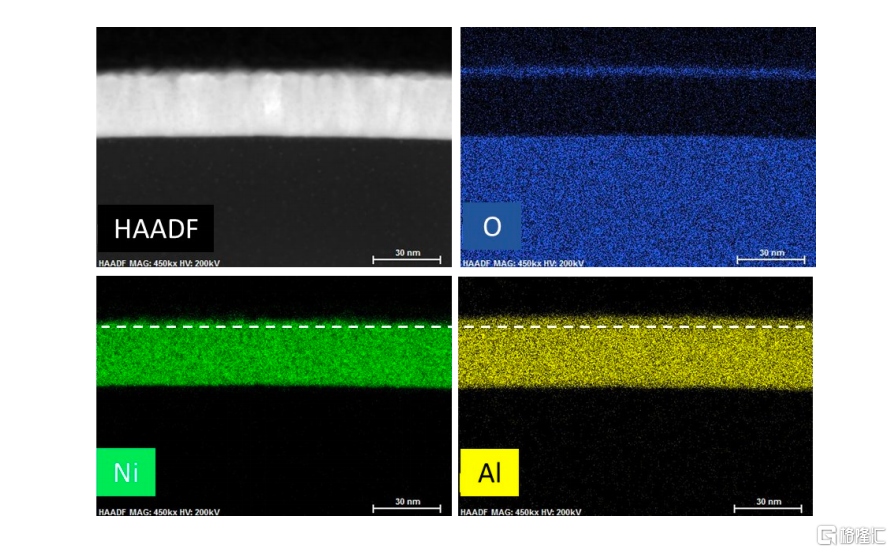
图 23. 30nm 厚的镍铝薄膜(二氧化硅/硅上)经空气曝光后的高角度环形暗场 TEM 图像以及 O、Al 和 Ni EDS 图。EDS 图像显示存在 AlOx 表面氧化物。
D
三元化合物
除了二元金属间化合物,人们还讨论了几种用于高级互连金属化的三元化合物。对于三元化合物,由于潜在的金属间化合物数量巨大,对其特性的了解非常有限,因此无法按照元素甚至二元金属间化合物的方法进行系统筛选。因此,迄今为止的研究仅限于特定的材料类别。最近,MAX 相尤其引起了人们的兴趣。MAX 相是层状六方碳化物或氮化物金属陶瓷,一般成分为 Mn+1AXn(图 24a),其中 1 ≤ n ≤ 3,M 为(早期)过渡金属,A 为 A 族元素,X 为 C 或 N。一些 MAX 化合物,如 Cr2AlC 和 V2AlC,显示出低于 10 µΩcm 的面内室温电阻率(图 24b)。一项非比筛选工作发现了几种 MAX 相的低ρ0 × λ 产物(见第二章 C 节),证实了它们在按比例互连金属化方面的潜力。

图 24. (a) 1 ≤ n ≤ 3 的 Mn+1AXn 结构,M 为(早期)过渡金属,A 为 A 族元素,X 为 C 或 N,(b) Cr2AlC 和 V2AlC 单晶的面内电阻率随温度的变化。转载自参考文献 233. (c) 铂钴氧化物的结构
另一种具有潜在意义的材料系统是二化石氧化物,尤其是钯钴氧化物或铂钴氧化物。这些层状六方化合物(见图 24c)显示出超低的体电阻率,与铝相当,但平均自由通路也较长。
一般来说,三元化合物与二元化合物面临着同样的挑战,上述关于成分控制等方面的讨论预计也适用于此。此外,MAX 和 delafossite 复合物都是(强)各向异性导体,仅在平面方向上电阻率较低。虽然这也有好处,可以抑制顶面或界面的表面散射(见第 II 章 A 3 节),但薄膜的晶体学取向变得至关重要,必须实现没有错向晶粒的完全(001)纹理薄膜。因此,要验证这些材料类别的潜力,还需要更多的实验验证。
E
超越二元和三元金属间化合物:一维金属和拓扑韦尔半金属
如第二章 A 节所述,各向异性导电性和尺寸减小可以抑制表面散射。因此,一维导体被提议作为最终的互连导体,因为在这种情况下,互连线上下表面和侧壁的散射都能被抑制。这与二维层状系统(MAX、delafossite 氧化物)形成鲜明对比,后者在两个方向上导电性良好,而在第三个正交方向上导电性较差。
与第二章 C 节中介绍的 ρ0 ×λ 张量类似,可以定义纳米线的优越性,其中包括表面散射抑制的影响。具有潜在意义的一维金属包括二元六方金属间化合物(如 CoSn、OsRu)、正交金属间化合物(如 VPt2、MoNi2)和三元硼化物(如 YCo3B2)。需要指出的是,目前还没有关于此类材料的薄膜研究结果明确显示其表面散射的抑制作用。此外,要集成到互连器件中,需要与互连线方向一致的高电导率单晶体。目前,还没有制造这种互连器件的途径。因此,要证明这种材料的潜力,还有很多工作要做。
此外,拓扑半金属元素既包含 Weyl 半金属元素,也包含作为子群的多折射铁氧体半金属元素,作为远距离技术节点的潜在互联材料,最近也引起了一些关注。Weyl半金属具有独特的电子结构,其特点是线性带散布和退化(Weyl)节点。特别是,它们具有高导电率表面态,这些表面态在拓扑上受到保护,并对无序状态具有鲁棒性。Weyl 半金属的例子包括 TaAs、TaP、NbAs、MoP 或 NbP。
对于拓扑半金属 NbAs,实验表明有效电导率确实会随着横截面积的减小而增加,不过还需要进一步努力在互连相关结构中验证这些观察结果。与一维金属类似,拓扑半金属需要单晶(外延)导线。此外,基于拓扑半金属的互联可靠性尚不清楚,需要进一步的基础研究才能实现随尺寸线性扩展的互联。
纳米级互连线路的线路电阻建模
图 16 中的电阻率趋势可用于设计互联线路电阻的校准模型,并以铜线电阻预测为基准。根据图 16 中的数据,最近报告了一种适用于 Ru 和 Ir 互连的简单几何模型,其宽度为 w,高度为 h = w × AR,纵横比为 AR。为了获得无障碍线路电阻趋势与线路宽度 w 的关系,我们从图 16 中 Ru 经过 420◦C 沉积后退火的数据中提取了电阻率趋势线与横截面积的关系。Ru 金属化方案还包括 0.3 nm 厚的粘附衬垫。
图 25 显示了 AR = 3(图 25a)和 AR = 5(图 25b)时,Ru 和 Cu 在不同扩散阻挡层和衬垫层组合厚度下的预测线路电阻。例如,模型显示,在线宽为 w = 8 nm、纵横比为 AR = 3、阻挡层和衬垫层总厚度为 2 nm 的情况下,Ru 互连线的线电阻比 Cu 的线电阻提高了约 3 倍。此外,电阻模型还有助于详细了解铜基和 Ru 基互连器件之间线路电阻交叉的根源。
对 Ru 和 Cu 电阻率的定量比较(见图 16)表明,与 Cu 相比,Ru 的线路电阻优势并非源于电阻率的大幅降低,而主要源于当 Cu 可靠性所必需的阻挡层和线路层被更薄的 Ru 粘附层取代时,导体体积的增加。尽管如此,电阻率缩放仍然起着重要作用。由于铜的体积电阻率非常低,无势垒替代金属的电阻率缩放不足必然会导致小尺寸的高电阻率,这将抵消导体体积增大带来的潜在收益。因此,无势垒金属化和有利的电阻率缩放必须相辅相成,才能实现低线路电阻。
虽然 AR 与材料的内在特性无关,但它在很大程度上取决于集成路线所能达到的效果。对于铜双层大马士革(图 2),由于采用了铜填充工艺,AR 值仅限于 2-3。然而,其他集成方案,如半大马士革集成(见图 26)--基于大马士革填充和直接金属蚀刻线图案化的组合--可以通过其他金属实现。
虽然铜蚀刻按比例绘制的高 AR 线仍然极具挑战性,但 Ru 和 Mo 反应离子蚀刻技术已经成熟。如图 25b 所示,将纵横比增加到 AR = 5 时,在 w = 8 nm 时,Ru 比 Cu(AR = 2 时)的线路电阻提高了 5 倍,阻挡层/线路的总厚度增加了 2 nm。
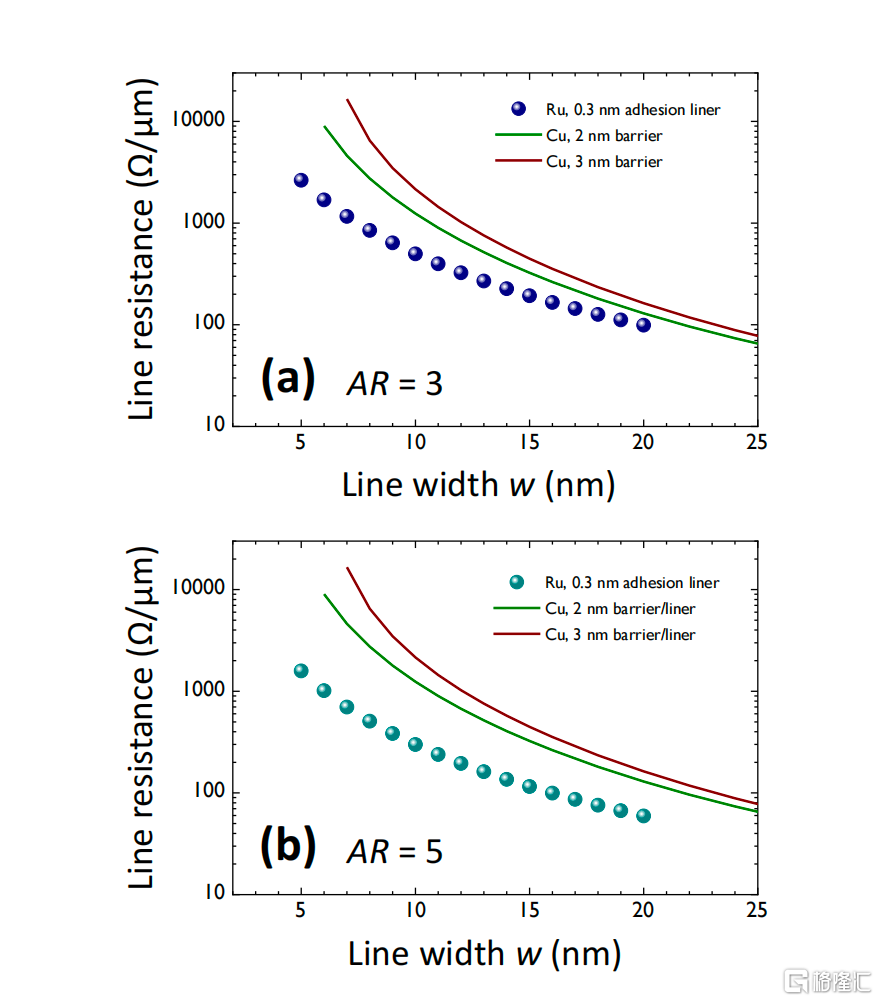
图 25. 以 Ru28 和 Cu 的校准模型为参考,在纵横比为 (a) AR = 3 和 (b) AR = 5 时的预测线电阻。Ru 模型包括 0.3 nm 厚的粘附衬垫,而 Cu 趋势线则分别显示了 2 nm 和 3 nm 厚的聚合阻挡层和衬垫。
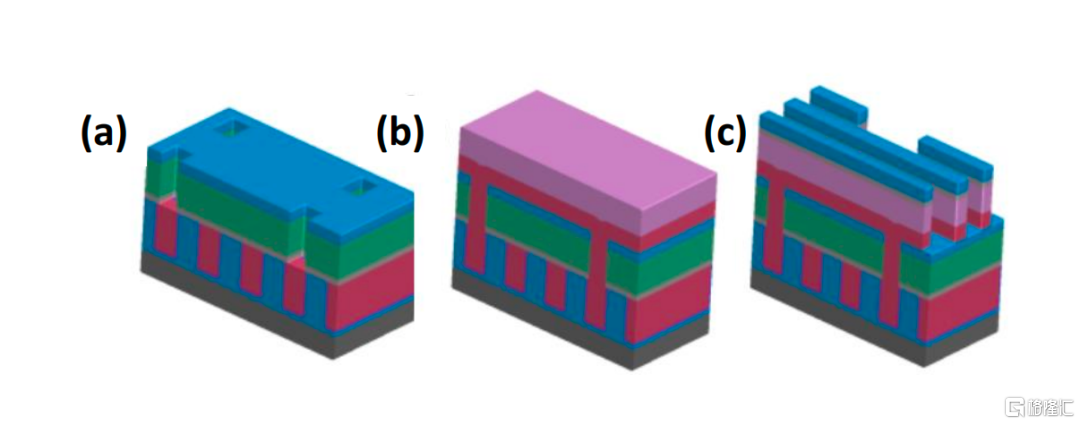
图 26. 半级联互连集成路线示意图;a) 通孔蚀刻;b) 通孔的金属填充,然后是金属过填充,c) 使用过填充金属层进行线路蚀刻。
工艺整合挑战的物质方面
最终,将替代金属集成到按比例互连中需要开发单元工艺步骤和图 3 中替代金属工作流程最后一步中的金属化(图案化)工艺模块。虽然对现有工艺技术和剩余差距的详细回顾超出了本教程的范围,但我们在此简要介绍了在开发按比例互连线制造过程中变得越来越重要的材料特性。
A
附着力和应力
互连金属化的一个关键特性是与周围(低κ)电介质的附着力。金属-电介质界面通常很薄弱,比金属-金属或金属-电介质界面薄弱得多,这可能导致金属薄膜脱层和灾难性后果。一般来说,贵金属与电介质的附着力要比贱金属弱得多,这是因为界面结合力较弱。由于与周围电介质或金属之间的范德华相互作用较弱,高质量石墨烯通常也具有较弱的附着力。
通过在主要金属(如贵金属)和周围电介质之间引入附着衬垫,可以改善附着力。然而,与扩散屏障的情况一样,这种粘附屏障会占用线路和通孔的体积,而对导电性的潜在贡献却很小。101 因此,钼金属化可以做到真正的无屏障和无衬垫。相比之下,惰性金属 Ru 与电介质的附着力不足,需要附着衬垫(如 TiN 或 TaN)。这表明,即使是非闭合薄膜也可以用作粘附衬垫,并表明这些衬垫可以比扩散屏障更好地扩展。不过,即使是 Ir 和 Rh 等惰性金属也可能需要进一步关注,以避免出现粘附力弱和分层现象。
薄膜(或整个叠层)中的高内置应力也会导致分层,从而进一步削弱界面。此外,填充过程中的高压应力和毛细力也会导致纳米结构变形,例如线摆动。应力并非金属的固有属性,而主要由沉积方法决定。尤其是 PVD 薄膜在沉积后会显示出很高(通常是拉伸)的应力。这可能与成核和生长的最初阶段孤岛凝聚过程中产生的应力有关,尽管整体行为可能很复杂。例如,沉积后的 PVD Mo 薄膜显示出高达 1500 兆帕的内置拉伸应力,这与薄膜厚度有关。然而,沉积后的退火和相关的晶粒生长强烈地改变了应力,甚至导致在一定温度窗口内冷却后产生压应力。
B
抗氧化性
在互连图形化过程中,一些金属表面可能会暴露在空气(或其他反应性环境)中,因此 化学惰性,特别是抗氧化性问题至关重要。即使是自我限制的表面氧化过程也会产生厚度约为 2 nm 的原生表面氧化物(实际上是电绝缘),通常会消耗约 1 nm 的金属。很明显,贵金属的化学性质比贱金属要强得多。虽然这也会导致较弱的附着力,并带来不同的相关挑战,但这使得贵金属更容易集成到互连工艺流程中。
复合金属的情况更为复杂。正如在第四章C节中讨论的 NiAl(见图 23),二元金属的表面氧化物可能是非共沸的,甚至在紧靠表面氧化物下面的区域也会导致成分改变。209,220 因此,在这种材料系统中,按比例互连线的成分控制非常具有挑战性,需要避免表面氧化。虽然这些问题原则上可以通过原位图案化和钝化或封盖来解决,但这会大大增加工艺的复杂性,因此在金属选择过程中应加以考虑。
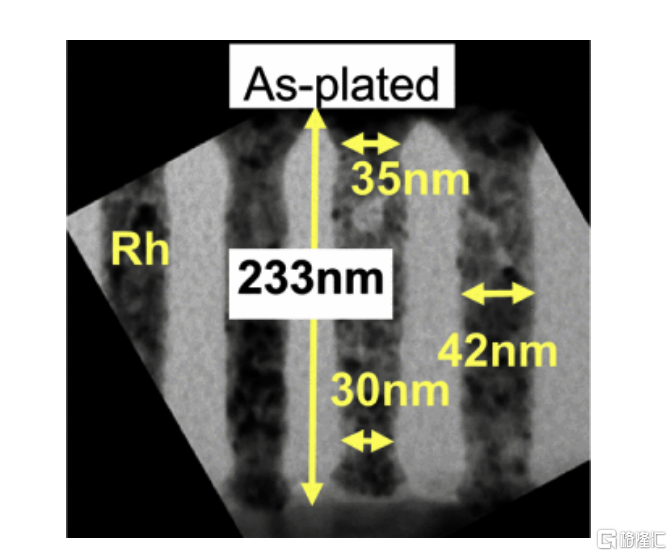
图 27. 通过 Rh 电镀填充的 < 40 nm 宽线的横截面 TEM 图像。
C
工艺技术
如上所述,对铜和替代金属集成工艺技术现状的详细回顾超出了本教程的范围。不过,从总体上看,每种互连集成路线都需要开发关键的单元工艺步骤,以制造一定规模的互连器件。双大马士革(图 2)和半大马士革集成路线(图 26)都需要采用电镀或化学气相沉积的金属沟槽和通孔填充工艺。
在双大马士革集成路线中,线路分离需要一个化学机械抛光(CMP)步骤,而在半大马士革集成路线中,线路是通过活性离子蚀刻(RIE)的直接金属蚀刻形成的。对于铜来说,CMP 工艺具有极佳的工艺控制能力,而 RIE 仍然具有很高的挑战性。因此,铜非常适合双级联集成,而半级联集成则不太适合。
对于替代金属而言,这意味着除了沉积工艺外,还必须具备具有所需特性和良好工艺控制的 CMP 和/或 RIE 工艺。例如,Rh 具有低电阻率和高熔点,具有很高的抗电迁移潜力。260 在限制附着衬厚度以避免导体体积减小的同时,附着工程仍面临挑战。Rh 可以电镀,并已证明可以填充宽 < 40 nm 的线路和具有高纵横比的通孔(图 27)。
然而,双层大马士革集成需要 CMP,这对 Rh 来说还不成熟,需要高腐蚀性的磨料和氧化剂。因此,还没有关于 Rh 的可制造 RIE 工艺的报道,这阻碍了半大马士革集成方法的发展。因此,缺乏可制造的 CMP 和/或 RIE 工艺仍然是在商用 CMOS 电路中实现 Rh 金属化潜力的主要障碍。
替代金属的可持续性
传统上,选择替代互连金属的标准主要侧重于技术、物理和经济属性。不过,考虑到将可持续性方面(SAs)纳入决策过程的重要性与日俱增,本节介绍了评估替代互连金属可持续性的简化框架。它包括七个可持续发展方面,并评估了当前和替代互连金属(铜、铝、镍、钌、钴、钼、铱、铑)的实例。在采用生命周期方法以避免转移环境负担时,必须考虑替代互连金属的整合方法。
了解集成过程中的材料和能源流对于衡量整体可持续性至关重要。虽然步骤较少的工艺通常会减少对环境的影响,但考虑集成过程中的能源需求也至关重要。本节将讨论这些对全面评估至关重要的集成考虑因素。此外,本节还简要概述了参考文献中详述的可持续性评估框架。
拟议的互联金属可持续发展评估框架分为七个可持续发展评估。每个 SA 至少有一个量化影响的指标。SA1 侧重于供应风险,利用赫芬达尔-赫希曼指数(HHI)估算市场集中度。表 IV 中的 HHI 值摘自参考文献 表 IV 中的 HHI 值摘自参考文献 265 和 266。SA2 涉及关键性和冲突,考虑了美国和欧盟关键原材料 (CRM) 列表中的金属以及欧盟冲突矿物列表。SA3 深入研究金属的循环性、 SA3 深入研究金属循环性,评估集成电路制造工艺中的材料使用情况,并承认计算现场材料循环性指数 (CI)270 是一项挑战。
SA4 通过全球升温潜能值 (GWP)271 评估对气候变化的影响,而 SA5 则重点关注缺水问题,采用 EF 3.1 方法272 评估上游用水情况。SA6 通过非生物资源耗竭潜能值 (ADP) 来研究对自然资源的影响,SA7 则使用 EF 3.1 方法评估对人类健康的影响,如 "人类癌症和非癌症毒性 "和 "颗粒物"。这些指标共同为替代性互连金属的可持续性提供了一个全面的视角。有关每个 SA 及其指标的更详细解释,请参见相关参考文献。
表 IV 概述了所研究的互连金属的可持续性表现,从细微处展示了七个拟议指标。可持续性影响(表 IV 中的 SA4-SA7)是根据生产 1 立方厘米金属的 "从摇篮到栅极 "影响计算的。这种计算方法假定最终沉积的互连金属层的体积与金属无关。不过,应考虑达到所需最终沉积体积所需的体积比。
评估金属沉积效率 ηdep 对于确定实际使用体积 Vu 至关重要。典型沉积工艺的 ηdep 值范围在 1% 到 20% 之间,适用于基于化学气相的沉积工艺275 ,但对于物理气相工艺,ηdep 值可能要高得多。此外,减法集成方案会导致进一步的材料损耗,这取决于集成工艺的材料使用效率 ηint,并受互连金属选择的影响。相比之下,大马士革集成方案需要在 CMP 之前沉积大量覆盖层,这也会导致 ηint ≪1。Vu 可定义为:

其中,VIC 是制造互连(层)的体积,由互连尺寸以及特定电路的通孔和线路密度决定。
通过表 IV 中 SA4-SA7 的体积影响,可以更准确地评估互连金属对特定可持续性方面 IXmet 的环境影响。

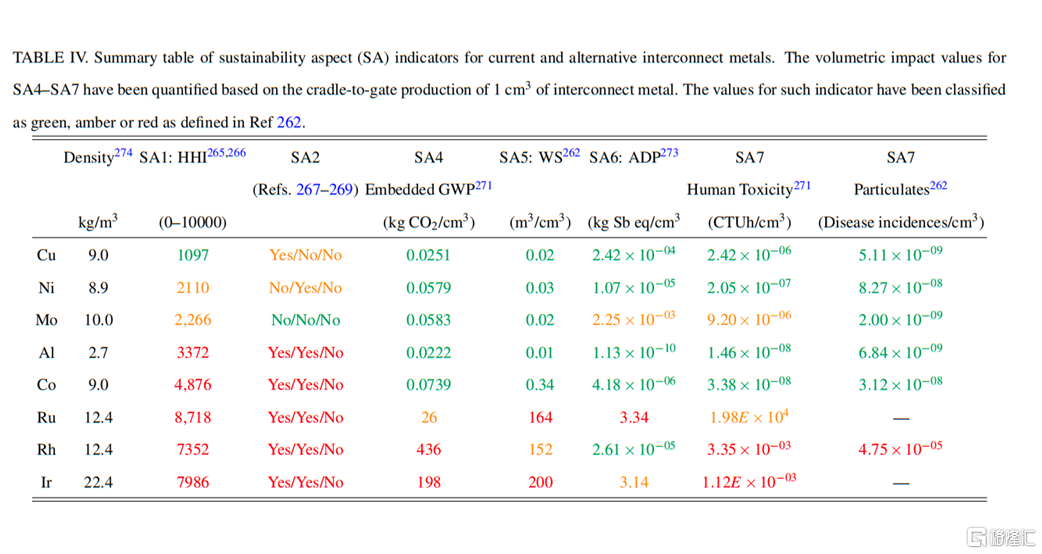
上述介绍简要概述了替代互联金属的简化可持续发展评估方法。拟议的七项可持续发展指标提供了一种全面的生命周期思维方法,可实现全面的可持续发展评估。对表 IV 中的体积影响值进行定性分析,有助于工艺工程师确定权衡。表 IV 中的定性分析可帮助工艺工程师确定权衡取舍,并为开发先进互连应用的明智决策提供支持。 值得注意的是,Al、Ni、Co 和 Mo 在七项指标中至少有三项表现相对较好,而铂族金属(Ru、Ir 和 Rh)在七项指标中至少有六项表现相对较差。
进一步的分析包括将表 IV 中的体积影响乘以消耗的金属总量。进一步的分析包括将表 IV 中的体积影响乘以实现固定功能所消耗的金属总量,即固定的沉积金属量。这包含了沉积和集成方法固有的材料使用效率。此外,建议应用归一化或加权因子,根据具体情况(如公司特定的可持续发展目标、承担财务风险的意愿或特定地点的法规/材料可得性)确定可持续发展指标的优先次序。结合技术评估,这种简化的可持续发展方法为决策者在选择先进互连应用的替代金属时扩展标准奠定了基础。
总结和结论
如今,互连金属间距的缩放已成为先进微电子芯片技术发展的关键重点。随着晶体管间距的扩展达到物理极限,缩小最小金属线间距已成为进一步缩小电路面积的主要策略。虽然通过堆叠可以提高晶体管密度,但这种方法也需要更紧密的金属间距来防止互连拥塞,从而抵消了堆叠带来的好处。
此外,互联 RC 时延在很大程度上限制了 CMOS 电路的吞吐量,这在几个技术节点上已经存在。为了控制 RC,必须优化金属化的电阻 (R) 和电容 (C)。 要优化 R,就必须在线路和通孔中填充电阻率尽可能低、体积尽可能大(在给定间距下)的金属,从而改进金属化方案。优化 C 需要使用低κ电介质或在线路之间形成气隙。不过,这方面的内容超出了本教程文章的范围。
目前的铜基双层金属化方案于 1999 年推出,由于多种原因,这种方案正面临越来越大的压力。为了满足可靠性标准,铜金属化需要阻挡层,以防止铜原子漂移或扩散到周围的电介质中,从而导致电介质击穿。迄今为止,TaN 仍是标准的阻挡层材料。此外,为了满足电迁移标准,还在铜和 TaN 阻挡层之间以及铜线顶部引入了钴衬垫层(全方位钴)。TaN 层和 Co 层在按比例互连器件中都占据了相当大的体积分数,但对线路电导的贡献却相对较小。
然而,这些 TaN 隔层和 Co 内衬层的厚度不可能无限制地减少而不影响其功能。尽管我们一直在努力扩大厚度限制,但要达到 1 纳米的综合厚度仍具有很大的挑战性。即便如此,在 10 nm 线宽的情况下,1 到 1.5 nm 的阻挡层和衬里组合厚度也将占据 20% 到 30% 的线体积,对线路电阻产生相当大的影响。此外,使用大马士革工艺对如此窄的线路进行无空隙填充的难度越来越大,这表明铜双大马士革金属化工艺很可能无法用于 20 纳米以下的金属间距。
在过去十年中,这些问题促使人们寻找铜(双大马士革)金属化的替代品。鉴于互连的结构简单,改进主要源于材料的选择,这使得替代互连金属化成为材料科学的一个引人入胜的领域。正如本问所示,寻找新型互连金属需要考虑多种标准的综合方法。虽然线路电阻是最关键的因素,但可靠性和热方面也不容忽视。正如经校准的窄线模型(第五节)所示,低线路电阻要求导体金属具有低电阻率和无屏障金属化,以最大限度地增加导体金属填充的可用体积。
因此,有前途的替代金属必须满足介电击穿和电迁移标准,而无需屏障。其他重要的材料标准包括与周围电介质的粘附性、内置应力和抗氧化性。此外,工艺就绪性和可持续性也不容忽视。
电阻和可靠性标准的结合促使人们关注难熔金属--它们具有良好的可靠性,而且电荷载流子的平均自由路径较短,从而促进了按比例尺寸的低电阻率。研究最初以元素金属为中心,但最近已扩展到二元和三元金属间化合物。在所有被研究的材料中,Ru 和 Mo 是迄今为止最有前途的。半导体行业正致力于开发必要的工艺技术,以便在不需要屏障的情况下将这些金属集成到 10 纳米以下的金属线中。这些金属良好的蚀刻性还开辟了其他集成途径,如半二叠纪集成,这可能允许更高的高宽比鼠线性,进一步降低线路电阻。因此,这些金属有望在未来十年内集成到未来技术节点的逻辑和存储器件中。
其他有前途的导体材料包括插层石墨烯,从长远来看,还包括拓扑材料,如韦尔半金属。目前,所有这些方法,包括二元和三元金属间化合物,都是以薄膜的形式进行研究的,它们在按比例导线中的行为仍是未知数。正如第 IV 章 C 节所述,与元素金属相比,将这些材料集成到互连器件中的复杂性要高得多。这些材料的可制造工艺技术之路才刚刚开始。尽管如此,人们对如此广泛的材料的兴趣,以及未来可能出现的更多材料类别,表明该领域在未来许多年仍将是材料科学的一个令人着迷的领域。
 下载格隆汇APP
下载格隆汇APP
 下载诊股宝App
下载诊股宝App
 下载汇路演APP
下载汇路演APP

 社区
社区
 会员
会员



